電子製品の中核アーキテクチャにおいて、PCB は精密に動作する「神経中枢」のようなもので、その性能は電子製品の安定性と信頼性を直接決定します。のコアリンクとしてプリント基板の製造プロセス、積層プロセスは、複数の材料層を安定した構造に融合する責任を負います。そのプロセス精度は、PCB の機械的強度と絶縁性能に影響を与えるだけでなく、信号伝送の完全性にも決定的な役割を果たします。以下では、PCB積層技術の全プロセスを分析し、その背後にある技術ロジックと品質管理ポイントを明らかにします。
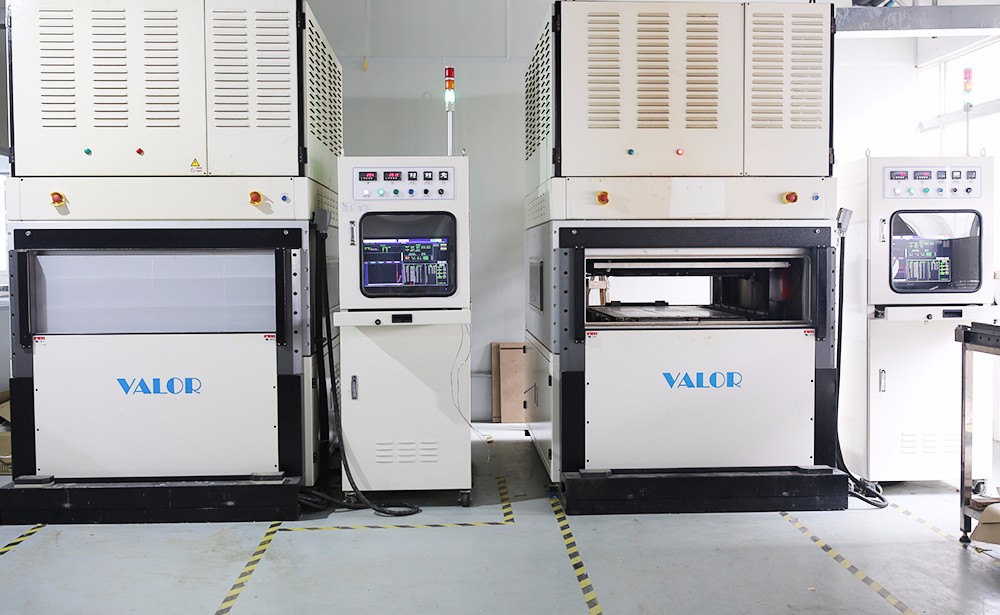
1、プレス前の正確な準備
(1) 素材の厳格な選定と入念な検査
As the electrical connection foundation of printed circuit board,the inner core board needs to undergo precision machining of inner circuit production to ensure that the accuracy error of circuit graphics is controlled within ± 5 μ m. In the appearance inspection stage, automatic optical inspection equipment is used to scan the entire surface of the core board, focusing on checking for short circuits, open circuits, and pinhole defects with a diameter of 50 μ m. At the same time, a micro resistance tester is used to conduct 100% testing of the circuit conductivity to ensure that the electrical performance of the core board meets the standard.
半硬化フィルムの性能パラメーターは、層間接着の品質を直接決定します。高周波通信プリント基板の場合、誘電率が 3.0 以下、誘電損失が 0.002 以下の低損失の半硬化チップを選択する必要があります。-自動車エレクトロニクスなどの信頼性の高いシナリオでは、ガラス転移温度が 170 度以上の高温耐性モデルを使用する必要があります。-材料入庫検査ではゲルタイムテスターにより樹脂の硬化活性を検出し、ゲルタイムの偏差を±10%以内に管理することが要求されます。同時に、厚さ試験機を使用してシートの均一性をスポットチェックし、厚さの公差が±5μm以下であることを確認します。
外側の銅箔の選択は、回路設計要件に一致する必要があります。パワーモジュールなどの大電流シナリオでは、厚さ70μmの高延性銅箔の使用を優先する必要があり、その剥離強度は1.5N/mm以上である必要があります。高周波信号線の場合は、表皮効果の影響を軽減するために、18 μm の超薄型銅箔を使用することをお勧めします。-銅箔の表面粗さは1.5~2.5μmの範囲に管理し、表面欠陥によるエッチング欠陥を除去するために粗さ測定器を用いてバッチサンプリングを行う必要があります。
(2) 緻密な設計と緻密な積層構造
スタッキング設計は、電磁両立性の原則に従う必要があります。 10 層を超える高速プリント基板の場合、通常、「信号層、層、電源層、信号層」の対称構造が使用されます。電源層と層の間の距離は50〜100μmに制御され、密結合した容量効果を形成し、電源ノイズを低減します。止まり穴の設計では、CAE ソフトウェアを使用して穴位置投影解析を行い、隣接する止まり穴の偏差が 50 μ m 以下であることを確認し、位置ずれによる層間の接続不良を回避します。一般的なケースでは、6 層の対称スタック DDR4 回路基板を使用すると、非対称構造と比較してシグナル インテグリティ シミュレーションの損失が 12% 削減されることがわかります。
スタッキング作業はクラス 1000 のクリーン ルーム環境で行われ、オペレータは人間の汚染物質の影響を避けるために静電気防止用の手袋とマスクを着用する必要があります。-視覚的アライメント システムを使用して材料の各層の位置を特定すると、X/Y 軸のアライメント精度は ± 25 μ m に達します。副資材には高耐熱性ポリイミド絶縁紙(耐熱温度260度以上)を選定し、厚み公差を±2μm以内に管理しています。クッション材には密度0.3g/cm3のガラス繊維フェルトを使用し、体圧分散のバランスを考慮しています。積層が完了したら、材料の合計の厚さを計量方法で確認する必要がありますが、誤差は ± 3% 以下です。
2、プレス動作の正確な制御
(1) 装置パラメータの微調整
温度制御はマルチゾーン温度制御技術を採用し、プレス鋼板の表面温度差は±1.5度以下です。あるFR-4材料を例にとると、その硬化曲線は予熱段階(60~120度、昇温速度3度/分)、硬化段階(180度±2度、90分間の断熱)、後硬化段階(80度以下まで徐々に冷却)の3段階に分かれています。赤外線温度計を使用してスラブの中心温度をリアルタイムで監視し、設定曲線からの偏差が± 3 度以下であることを確認します。
圧力調整にはサーボ油圧システムを採用し、圧力勾配は5psi/mm以内に制御されます。 8 層プリント基板の場合、初期圧力は 150 psi に設定されます。温度が120度(樹脂溶融段階)まで上昇したら、圧力を400psiまで徐々に上げ、保持段階での圧力変動は±10psi以下です。大面積パネル (400mm × 500mm 以上) では、ゾーン圧力補償機能を有効にする必要があります。この機能は、圧力センサー マトリックスを通じて局所圧力を動的に調整し、板厚均一性誤差が ± 5 μ m 以下であることを保証します。
時間管理は、「温度、圧力、時間」の 3 次元相乗効果原理に従います。-実験データによると、180度/400psiの条件下では、半硬化シートが完全に硬化するまでに85~95分かかり、80分未満では層間剥離強度が20%以上低下します。厚い銅箔 (70 μ m 以上) のプロセスでは、銅箔の凹部に樹脂が完全に充填されるように、保持時間を 15 ~ 20 分延長する必要があります。
(2) プレス工程のリアルタイム監視
加熱段階中、PLC システムは温度変化を毎分記録し、加熱速度が 5 度/分を超えると自動的にアラームがトリガーされます。この段階では、樹脂の溶融状態を観察することに重点が置かれます。理想的には、半硬化シートは 90 ~ 110 度の範囲で流動状態を示し始めます。早期溶解が発生した場合 (80 度未満など)、材料の保管環境を確認する必要があります (湿度は 5% RH 以下である必要があります)。
断熱および圧力維持の段階では、圧力トランスミッターを使用してシリンダー圧力をリアルタイムで監視します。圧力変動が±15psiを超えると、システムは自動的に補償ポンプを起動して圧力を補正します。同時に、鋼板の内側に取り付けられた熱電対センサーを通じて温度データが 5 分ごとに記録され、プロセスのトレーサビリティと最適化のための温度時間曲線が形成されます。
冷却ステージには勾配冷却技術が採用されており、まず装置を 120 度以下まで自然冷却し (冷却速度 5 度/分以下)、次に空冷トンネル (風速 2~3m/s) に移して室温まで冷却します。-高 TG 材料 (Tg 180 度以上) の場合、内部応力の蓄積を軽減するために 80 度を超える温度で 30 分間ゆっくり冷却する必要があります。テスト後、このプロセスによりプリント基板の反りを 40% 以上削減できます。
3、厳密なテストと圧縮後の取り扱い
(1) 外観欠陥の入念な検査
目視検査はマルチアングル光源照明(色温度5000~6500K)を採用しており、検査員は2年以上の経験があり、直径0.3mm以上の気泡や長さ1mm以上の剥離欠陥を識別できる必要があります。エッジオーバーフローの場合、レーザー厚さ計を使用してオーバーフロー厚さを検出します。その後のフライス加工精度への影響を避けるために、0.1 mm 以下という要件があります。
50-200倍の光学顕微鏡を使用した顕微鏡検査。ブラインド埋め込み穴接続部の樹脂充填状況の観察に重点を置き、空隙率5%以下が必要です。高密度回路領域の場合、スライス解析を通じて層間アライメントをチェックする必要があります。- X/Y軸オフセットは50μm以下、Z軸樹脂厚み均一性誤差は±10%以下としてください。
(2) 寸法・厚さの正確な測定
サイズ測定には画像測定器を採用し、基板の長さ、幅、開口位置を自動スキャンし、座標精度±10μmで測定します。不規則なプレートの場合、CAD データのインポートを通じて輪郭のマッチングが実現され、寸法公差は ± 0.05 mm 以内に制御されます。
厚み検出はマイクロメーターを使用し、プレートの四隅と中央の計5点を測定します。平均厚さは設計値からの誤差が±3%以内、各測定点の厚さ範囲は50μm以下です。多層基板の場合-、X線厚さ計を使用した各層の銅厚の非破壊検査-が必要です。内層の銅厚偏差は±10%以下、外層銅厚偏差は±5%以下です。-
(3) 効果的な欠陥修理と製品の適切な取り扱い
欠陥修復: 面積が 5mm 2 以下の気泡については、真空ホットプレス修復技術 (温度 180 度、圧力 600psi、時間 10 分) が使用されます。修理後は再スライス検証が必要です。回路内の微小なショートに対しては、レーザーマイクロエッチング装置(スポット径50μm以下)を用いて正確にショート箇所を除去し、修復後フライングピンテストにより導通を確認します。統計によると、軽微な欠陥の修復の成功率は 90% 以上に達しますが、修復の回数は 2 回以下に制限されています。
Establish strict defect grading standards for scrapping, and determine scrapping for any of the following situations: ① interlayer separation area>100mm ²; ② Key signal network open circuit/short circuit; ③ Warping degree>1.5%; ④ Aperture deviation>±100μm。スクラップ製品は破砕する必要があり、プロセス改善のトレーサビリティのためにERPシステムを通じてスクラップの理由を記録する必要があります。
printed circuit board lamination process is a complex manufacturing process that integrates material science, hot pressing transfer, and precision control. Its technical points run through the entire chain of "material preparation layer design lamination execution detection and repair". By precise material selection, scientific stacking planning, intelligent equipment control, and strict quality inspection, the comprehensive performance indicators of printed circuit boards can be effectively improved.

